
 | |
|
Меню
Главная
Прикосновение космоса
Человек в космосе
Познаем вселенную
Космонавт
Из авиации в ракеты
Луноход
Первые полеты в космос
Баллистические ракеты
Тепло в космосе
Аэродром
Полёт человека
Ракеты
Кандидаты наса
Космическое будущее
Разработка двигателей
Сатурн-аполлон
Год вне земли
Старт
Подготовки космонавтов
Первые полеты в космос
Психология
Оборудование
Модель ракеты
|
Космонавтика Инверторы индукционного нагрева транзисторам преимущества включают: Свойство почти бесконечного входного импеданса: - управляемый напряжением вход; - низкая входная мощность; - незначительное число компонентов цепи управления; Очень маленькие времена переключения: - нет неосновных носителей; - минимальное время задержки выключения; - большая область безопасной работы при обратном смещении; - большое произведение коэффициента усиления и полосы частот; Положительный температурный коэффициент сопротивления в открытом состоянии: - большая область безопасной работы при прямом смещении; - легкость параллельного соединения; Почти постоянную крутизну; Высокую невосприимчивость к dv/df; Низкую стоимость. Направление разработки мощного МОП-транзистора TMOS фирмы Motorola - дальнейший шаг в постоянном продвижении, которое началось с обычного маломощного МОП-транзистора и привело к замене промежуточного горизонтального МОП-транзистора с двойной диффузией (LDMOS-транзисторы) и вертикального с V-каналом (VMOS-транзисторы). Обычный маломощный МОП-транзистор с горизонтальным N-каналом состоит из подложки Р-типа с малой концентрацией примеси, в которой образованы путем диффузии две N* области с большой концентрацией примеси, как показано на рис. 1.3. N+ области действуют как исток и сток, отделенные каналом, длина которого определяется путем фотолитографического ограничения. Эта конфигурация приводит к большой длине канала, малому допустимому току, низкому обратному запирающему напряжению и большому сопротивлению в открытом состоянии Го8(оп)-  1.3. Обычный маломощный МОП-транзистор (имеет длинный гсризонтальный канал, даюищй относительно высокое сопротивление сток-исток затвор; 2-ток; 3-обедненная область; 4-N-канал (путь тока); 5-Р-гюдложка; 6-металлический исток; 7-металлический сток. В основе эволюции мощного МОП-транзистора лежит два основных изменения в устройстве малосигнального МОП-транзистора. Одним из них было применение метода направленной двойной диффузии для достижения очень малой длины канала, что обеспечило более высокие плотности ггомпановки канйла, приведшие в результате к более высокому допустимому значению тока и более чизкому значению сопротивления в открытом состоянии гс8(оп)- Другое изменение - включение слабо легированной области N между каналом и N+ стоком, обеспечивающее высокое обратное запирающее напряжение. В результате этих изменений была получена структура мощного полевого транзистора (LDMOS), показан- Si02 КАНАЛ Рис. 1.4. Структура горизонтального, с двойной диффузией МОП-транзистора, обладающая малой длиной канала и высокой плотностью компановки для низкого сопротивления в открытом состоянии. ная ка рис. 1.4, в которой все зажимы прибора находятся на верхней поверхности кристалла. Основной недостаток такой конфигурации заключается в неэффективном использовании площади кремния вследствие того, что необходима площадь для контакта стока на верхней поверхности. Следующая ступень в процессе развития - вертикальная структура, в которой контакт стока находится на нижней стороне кристалла. При этом увеличилась плотность компановки канала. В первоначальной. концепции использован мощный МОП-транзистор с V-каналом, как показано на рис. 1.5. Каналы в этом приборе получаются путем травления V-канавок через N+ и Р-области, полученные путем двойной диффузии. В данной конфигурации выполняются требования достаточной плотности компановки, эффективного использования кремния и достаточного обратного запирающего напряжения. Однако вследствие непланарной структуры последовательность процессов и требования чистоты приводят к более высокой стоимости кристалла. 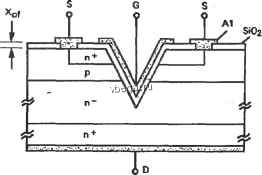 Рис 1.5. Структура МОП-транзистора с V-каналом (имеет короткие вертикальные каналы с малым сопротивлением сток-исток). Структура ячейки, выбранная для мощного МОП-транзистора TMOS фирмы Motorola показана на рис. 1.6. Эта структура подобна структуре, показанной на рис. 1.4, за исключением того, что контакт стока опущен через N-подложку к обратной стороне кристалла. Затвор представляет слой поликристаллического кремния, расположенный между двумя слоями оксида и металлизация истока нанесена непрерывно поверх активной площади. Двуслойный электрический контакт дает оптимум плотности компановки и повторяет тех- 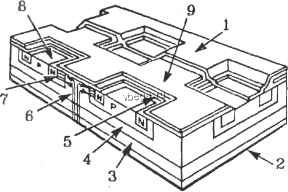 Рис. 1.6. Структура мощного МОП-транзистора TMOS с вертика.чьны.м протеканием тока, низки>1 сопротив.чением и компактной .кета.1-лизацией верхней и нижней поверхностей, понижающей размеры кристатла: J-исток: 2-сток; 3-И-подложка; 4-N-эпшпаксиальный слой; 5~ Sl02; 6-гаок стока: Т-К-канол: 8-поверхность истока; V-кремниевый затвор. нологические преимущества планарного транзистора LDMOS. Примененные приемы приводят к высокопроизводительному технологическому процессу, дающему выход высоковольтных приборов с низким сопротивлением открытого состояния Гоз(ог)- Основные электрические параметры мощного полевого МОП-транзистора Ток стока 1р: Когда напряжение соответствующей полярности и величины приложено к затвору, затвор из поликристаллического кремния индуцирует инверсионный слой на поверхности области диффузионного канала, обозначенный Ген на рис. 1.7. Этот инверсионный слой или канал присоединяет исток к слабо легированной области стока и начинает протекать ток. Для малых значений приложенного напряжения сток-исток Vqs ток стока возрастает линейно и может быть представлен уравнением (1). По мере того как напряжение стока увеличивается, ток стока насыщается и становится пропорциональным квадрату приложенного напряжения затвор-исток, Veg, как показывает уравнение (2). где - подвижность носителей; Со - емкость оксидного слоя затвора на единицу площади; Z - ширина канала; L - длина канала. Эти значения выбираются разработчиком прибора таким образом, чтобы удовлетворить требованиям проекта и могут быть применены при моделировании и расчете схемы на ЭВМ. Они объясняют форму выходных характеристик. Крутизна gfg: Крутизна или коэффициент усиления мощного МОП-транзистора TMOS определяется как отношение изменения тока стока и соответствующего небольшого изменения напряжения затвор-исток и представлена уравнением (3). g/s = D(sat)VCS = jhCo[VGS-VcS(th)] < 3> Параметры те же самые, что и приведенные выше, и показывают, что ток стока и крутизна непосредст- 1Ю1И11НН1Ш11Г11И1111Н1111И111И1П 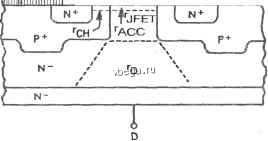 Рас. 1.7. Сопротивление открытого состояния транзистора TMOS венно связаны и зависят от кристалла. Отметим, что крутизна - линейная функция напряжения затвора - важное свойство при проектировании усилителя на ПТ. Пороговое напряжение Vcjs(t}i) Пороговое напряжение - напряжение затвор-исток, требующееся для достижения инверсии области диффузионного канала (гсн на рис. 1.7), приводящей к появлению проводимости канала. По мере увеличения напряжения канал увеличивается, его сопротивление уменьшается и протекающий ток увеличивается. Чтобы сохранить корреляцию измерений, пороговое напряжение измеряется при заданном значении тока (обычно 0,1 мА). Значение порогового напряжения, в первую очередь, зависит от толщины оксидного слоя затворч и уровня примеси в канале, которые выбираются при проектировании кристалла таким образом, чтобы прибор оставался в запертом состоянии при отсутствии смещений на затворе при высокой температуре. Минимальное значение порогового напряжения 1,5 вольт при комнатной температуре .гарантирует, что транзистор останется в режиме усиления при температуре перехода до 150Х. Сопротивление открытого транзистора rDS(on) Сопротивление открытого транзистора определяется как полное сопротивление на пути тока стока, протекающего от истока до стока. В соответствии с рис. 1.7 сопротивление rQS(on) состоит в основном из четырех компонентов, связанных с: инверсионным каналом-Ген. областью накопления затвор-сток - Гдсс. областью сужения перехода полевого транзистора - rjFEj и слабо легированной областью стока - Гц: DS(oii )=fСН+ГасС+Г/рЕТ+Го Сопротивление канала увеличивается с увеличением его длины, сопротивление накопления увеличивается с увеличением ширины поликристаллического затвора, и сопротивление сужения увеличивается с увеличением удельного сопротивления эпитаксиального слоя и все три компонента обратно пропорциональны ширине канала и напряжению затвор-исток. Сопротивление стока пропорционально удельному сопротивлению эпитаксиального слоя, ширине поликристаллического затвора и обратно пропорционально ширине канала. Таким образом, в полевых транзисторах TMOS с толстым эпитак-сиальным слоем, обладающим высоким удельным сопротивлением, большая доля напряжения в открытом состоянии приходится на Гр. Приборы с низким напряжением имеют тонкий эпитаксиальный слй с низким удельным сопротивлением и Грн составляет боль- Шую долю полного сопротивления в открытом состоянии. Поэтому высоковольтные приборы полностью открыты при умеренных напряжениях на затворе, в то время как в низковольтных приборах сопротивление открытого состояния продолжает уменьшаться по мере того, как Vgs увеличивается до максимального паспортного значения. Сопротивление Гоз(оп) обратно пропорционально подвижности носителей. Это значит, . что Гсз(оп) МОП-транзистора с. р-каналом приблизительно в 2,&-3 раза больше, чем для подобного МОП-транзистора с N-каналом. Поэтому для того, чтобы подобрать под пару комплементарные характеристики в открытом состоянии, отношение r/L прибора с Р-каналом должно быть в 2,5-3 раза больше, чем для прибора с N-каналом. Это значит, что для МОП-транзистора с Р-каналом с тем же самым Го8(оп) тем же напряжением прсСоя, что и для прибора с N-каналом, требуется больший кристалл и поэтому емкости прибора и стоимость будут соответственно выше. Напряжение пробоя V(BR)DSS Напряжение пробоя или обратное запирающее напряжение мощного полевого транзистора TMOS определяется таким же образом, как и Vjbrjces биполярного транзистора и объясняется лавинным пробоем. Этот предел напряжения достигается, когда носители в области пространственного заряда (ОПЗ) обратно-смещенного P-N-перехода приобретают достаточную кинетическую энергию для ионизации или когда достигнуто критическое значение электрического поля. Величина этого напряжения определяется главным образом характеристикой слаболегированной области стока и типом поверхностного электрического поля кри-СТ8ЛЛВ. На рис. 1.8. схематически представлено попереч-tlC9 сечение прибора и на рис. 1.9 изображен бипо-лярсзый транзистор, встроенный в эпитаксиалькый слой. Точка А (рис. 1.8) показывает, где эмиттер и база биполярного транзистора соединены вместе. Это обь-ясняет, почему Vjbrjdss мощного полевого транзистора равно V(Qn)ces биполярного транзистора. Так же отмечаем короткое замыкание, приводящее базу в контакт с металлизвцдей истока, допускающее использование перехода база-коллектор. Это диод, присоединенный 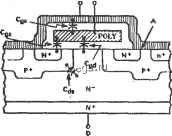 Рис 1.8. Паразитные емкости транзистора TMOS Риа 1.9. Схематическое изображение всех компонентов поперечного сечения, показанного на рис. 1.7. параллельно мощному МОП-транзистору TMOS. Емкости мощного МОП-транзистора TMOS Для мощного МОП-транзистора характерны два типа емкостей: емкости, чязанные с МОП-структурой и емкости, связанные с P-N-переходом. Две емкости связаны с ячейкой МОП-транзистора: - емкость затвор-исток Cgs - емкость затвор-сток Cgd Величины этих емкостей определяются геометрией кристалла и слоев оксида, связанных с кремниевым затвором. P-N-переход, образующийся при изготовлении мощного МОП-транзистора, приводит к возникновению емкости сток-исток Cds. Эта емкость определяется так же, как и емкость любого другого планарного перехода и является непосредственной функцией площади канала стока и ширины обедненной области смещенного в обратном направлении P-N-перехода. Диэлектрическим изолятором Cgs и Cgj служит главным образом стекло. Поэтому эти емкости очень стабильны и не изменяются при изменении напряжения и температуры. Если к затвору приложено чрезмерное напряжение, происходит пробой через стекло. При этом возникает путь проводимости и нарушается действие МОП-транзистора. Оптимизация геометрии TMOS: Геометрия и плотность компановки МОП-транзистора фирмы Motorola г;зменяется в зависимости от величины запирающего обратного напряжения. Геометрия местоположения истока, а также расстояние между местоположениями истока представляют важные факторы в эффективном проектировании мощного МОП-транзистора. Оба параметра определяют плотность компановки канала, т.е. отношение ширины канала на ячейку к площади ячейки. Для низковольтных приборов ширина канала является критической для минимизации rQS(on). поскольку сн - основная составляющая компонента Го8(оп). ОД нако при высоком напряжении Го - главная компонента сопротивления и, таким образом, минимизация гс8(оп) зависит от максимизации отношения активной площади стока на ячейку к площади ячейки. Эти два условия для минимизации Го8(оп) не могут быть удовлетворены при одной и той же геометрии структуры для приборов как низкого, так и высокого напряжения. Преимущества мощных МОП-транзисторов Мощные МОП-транзисторы обладают специфическими характеристиками и параметрами, недостижимыми для мощных биполярных транзисторов. Используя преимущества этих различий, можно получить экономию в стоимости системы без ущерба для надежности. Быстродействие (скорость переключения) Мощные МОП-транзисторы - приборы основных носителей, поэтому их скорость переключения по своей природе выше. Поскольку отсутствует накопление неосновных носителей в базе, присущее биполярным транзисторам, исключается время накопления. Высокие скорости переключения допускают эффективное переключение при более высоких частотах, что снижает стоимость, размеры и вес реактивных элементов. Скорости переключения МОП-транзистора зависят главным образом от заряда и разряд? емкостей прибора и по существу не зависят от рабочей температуры. Входные характеристики Затвор мощного МОП-транзистора электрически изолирован от истока слоем оксида, который представляет сопротивление постоянному току больше 40. МОм. Приборы полностью открыты при напряжении на затворе 10 вольт. Большое входное сопротивление
|
|||||||||||||||||