
 | |
|
Меню
Главная
Прикосновение космоса
Человек в космосе
Познаем вселенную
Космонавт
Из авиации в ракеты
Луноход
Первые полеты в космос
Баллистические ракеты
Тепло в космосе
Аэродром
Полёт человека
Ракеты
Кандидаты наса
Космическое будущее
Разработка двигателей
Сатурн-аполлон
Год вне земли
Старт
Подготовки космонавтов
Первые полеты в космос
Психология
Оборудование
Модель ракеты
|
Космонавтика Электроизоляционные конструкции и изоляторы :§ 10-3] Основные параметры полупроводниковых материалов Проводимость полупроводников зависит от концеитрацни свободных носителей заряда (электронов или дырок) при данной температуре и их подвижности. В общем случае o = - = e(nii + piip), где о-удельная проводимость при данной температуре; р - удельное сопротивление; и, р -концентрация свободных носителей; Рис. 10-1. Измерение удельного сопротивления двухзоидовым методом. 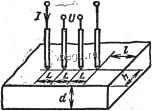 Рис, 10-2. Измерение удельного сопротивления четырехзондовым методом. fin И - подвижности электронов и рок при данной температуре. В настоящее время имеется много методов измерения удельного сопротивления: двухзондовый, трехзоцдовый, четырехзоидо-вый, бесконтактный и др. Наибольшее распространение получили двухзондовый и че-тырехзондовый методы. Двухзондовый метод применяется для -измерения удельного сопротивления образцов, имеющих правильную геометрическую форму с известным поперечным сечением (рис. 10-1). Через торцовые грани образца -с нанесенными на них омическими контак- - тами пропускается электрический ток. На поверхности образца вдоль линии тока располагаются два металлических зонда на расстоянии L друг от друга и измеряется разность потенциалов О между ними. Удельное сопротивление образцов вычисляется по формуле US UdB Для исключения падения напряжения на контактных сопротивлениях зондов разность потенциалов U измеряется либо по- тенциометром, либо вольтметром с большим входным сопротивлением. Четырехзондовый метод, обладая высокими метрологическими показателями и простотой конструкции, получил наиболее широкое применение. Он позволяет измерять удельное сопротивление не только объемных монокристаллов, но и тонких диффузионных и эпитаксиальных слоев полупроводника. Принцип четырехзондового метода показан на рис. 10-2. На поверхности полупроводника помещаются четыре зонда, расположенные на одной линии на равном расстоянии L друг от друга; через крайние зонды пропускают электрический ток /, а  Рис. 10-3. Поперечное поле, обусловленное эффектом Холла. между двумя внутренними зондами измеряется разность потенциалов U. Для полубесконечного образца, когда d, I, ЛL, удельное сопротивление вычисляется по формуле р = 2лШ . При измерении образцов полупроводника с размерами d, I, h, соизмеримыми с межзондовым расстоянием L, вводится поправочный множитель F, который зависит от граничных условий измерения. Значения ЭТОГО множителя приводятся в специальной литературе [10-1]. В этом случае удельное сопротивление р=.2лШ . Концентрация и подвижность. Определение концентрации и подвижности носителей заряда в полупроводниках производится с помощью эффекта Холла, сущность которого в следующем. Если поместить однородный прямоугольный образец полупроводника в магнитное поле, перпендикулярное направлению тока, протекающему по образцу, то на боковых гранях возникает поперечная разность потенциала, называемая ЭДС Холла (рис. 10-3) V -Vb=RIB/d. откуда R = (Va-Vb)d/IB, где Va - Vb - холловская разность потенциала; R - коэффициент Холла; / - ток через образец; В - магнитная индукция; d -толщина пластинки в направлении магнитного поля. В общем виде коэффициент Холла определяется выражением 1 -niil + Plil -пЬ+р е {пр, + .ср,р)? (пЬ + рГ-е где b - отношение подвижностей. В частных случаях для резко выраженных типов полупроводников коэффициент Холла равен: R-\lne или 1/ре. Эффект Холла позволяет определять тип проводимости полупроводника (по знаку возникающей между точками А п В разности потенциала), концентрацию и подвижность носителей заряда при совместном измерении проводимости образца. Для полупроводника резко выраженного типа подвижность Для определения в полупроводниках концентрации носителей заряда в лабораторной и производственной практике используется ряд методов [10-1, 10-2]; метод вольт-фарадных характеристик барьера Шоттки, метод плазменного резонанса, по оптическому поглощению, по эффекту Фа-радея и др. Концентрации донорных и акцепторных примесей, энергия их ионизации, ширина запрещенной зоны. Для характеристики относительной чистоты полупроводника вводится понятие - степень компенсации К, равная для полупроводника -типа где Ло, ЛСд - концентрации акцепторных и донорных примесей. Концентрации могут быть определены на основе измерения температурной зависимости концентрации и подвижности свободных носителей заряда по эффекту Холла [10-1-10-3]. в соответствии с законом действующих масс зависимость концентрации электронов дырок от температуры дается следующими соотношениями: для электронного полупроводника п (JVa Ч- п) 1 /2ят Г\э/2 ЛГд-а-п ~ Тд 1 Ш ) X ехр V kT для дырочного полупроводника р (ТУд + р) 1 [ 2пщкТ \э/2 Na-N-P X ехр равновесия; \д, Ya -факторы вырождения донорного и акцепторного уровней; д, Wa - энергии активации донорной и акцепторной примеси. Экспериментально полученные зависимости концентраций п и р от температуры сопоставляются с последними соотношениями. С помоиЦ)Ю ЭВМ подбором параметров Ya, \я, Na, Wa, Wp, добиваются наилучшего соответствия теоретической и экспериментальной кривых. Исследуя температурную зависимость концентрации в области собственной проводимости, можно определить ширину запрещенной зоны AW (см. §3-1). Время жизни. При расчете и конструировании различных полупроводниковых приборов всегда используется параметр - время жизни неосновных носителей зарят да т или диффузионная длина Lb, которые связань! между собой соотношением Z,d = гн, где D - коэффициент диффузии. Коэффициент диффузии и подвижность связаны соотношением Эйнштейна D=kTiile (в невырожденном полупроводнике). Наиболее распространенный метод измерения времени жизни носителей заряда по изменению фотопроводимости кристалла во времени после прекращения действия света на полупроводник и определяется из следующего соотношения: 0ф=(Тое~, где со - удельная проводимость проводника в темноте; оц - удельная проводимость полупроводника после прекращения освещения; t - время; т - время жизнн неосновных носителей заряда. Кроме этого метода существует большое количество других методов определения диффузионной длины Ld и времени жизии неосновных носителей заряда, описанных в соответствующей литературе. Поверхностная рекомбинация. Помимо рекомбинаций в. объеме носители могут ре-комбинировать на поверхности полупроводника. Скорость поверхностной рекомбинации S определяется как скорость потока частиц из объёма к поверхности, необходимого для поддержания на ней избыточного числа неравновесных носителей заряда. Значение S сильно зависит от способа и качества обработки поверхности кристалла. Например, для германия она колеблется от 0,1 до 10* м/с. Структура зон и эффективные массы. Эффективная масса носителя /и* характеризует его движение в кристаллической решетке. Обратная эффективная масса (/и*) - тензорная величина, определяемая зависимостью энергии носителя от его волнового вектора k: т7 (k) dkidkj где k - постоянная Больцмана; Т - абсолютная температура; Лд, /Са - константы Прямым методом определения W{k) и ективных масс является циклотронный резонанс. Ценные сведения о зонной струк- туре и эффективных массах дают измерения анизотропии магннтосопротивления, магнитооптических эффектов. Качественные строения зон наиболее распространенных полупроводников приведены на рис. 10-4-10-8.  Рис. 10-4. Зонная структура германия.  Рис. 10-5. Зонная структура кремния.  Рнс. 10-6. Зонная структура a-Sn.  Рнс. 10-7. Зонная структура InSb. ШАз, ШР, GeAa, GaSb. [т]- Wry, Рис. 10-8. Зонная структура GaP, AlSb. А1Аз. 10-4. ЭЛЕКТРОФИЗИЧЕСКИЕ ПАРАМЕТРЫ ПОЛУПРОВОДНИКОВ Кремний и германий. Кремний н германий - наиболее изученные и широко используемые полупроводниковые материалы (табл. 10-1-10-3). Они относятся к IV группе таблицы Менделеева. Кристаллизуются в решетке типа алмаза. Имеют сложную зонную структуру (рис. 10-4, 10-5). В кремнии имеется шесть эквивалентных минимумов зоны проводимости, расположенных на осях [100] внутри зоны Бриллюэна, а в германии - восемь минимумов на осях [111], расположенных по краю зоны Бриллюэна. Вблизи этих минимумов нзоэнерге-тические поверхности имеют вид эллипсоидов вращения с тензорной эффективной массой. Уравнение эллипсоида вращения для этих псжерхиостей имеет вид: W(k) I kl + kl kl \ где т 11 и - продольная н поперечная эффективные массы. Большие полуоси эллипсоидов расположены в кремнии вдоль направлений [100], а в германии - вдоль [111]. В Si шесть эквивалентных эллипсоидов вращения, а в Ge - четыре полных эквивалентных эллипсоида (или восемь половинок эллипсоидов). В кремнии и германии валентные зоны расщеплены на три подзоны Vi, V2, Vs, две из которых вырождены в точке =0, а третья расщеплена спнн-орбитальным взаимодействием на величину Aso- Зона Vj называется зоной тяжелых дырок, а зона Уг - легких дырок. Связь между энергией в первых двух подзонах U7 2 с волновым вектором описывается уравнением вида где U7(,- значение W при К=0; А, В, С- безразмерные коэффициенты; то -масса ~ свободного электрона. В сферической систе-
|
||||||||||